



相关文章
Related Articles详细介绍
EVG501 晶圆键合机 微流控加工
用于学术和工业研究的多功能手动晶圆键合系统。
适用于:微流体芯片,半导体器件处理,MEMS制造,TSV制作,晶圆先进封装等。
一、简介
EVG501 晶圆键合机 微流控加工是一种高度灵活的晶圆键合系统,可处理从单芯片到150 mm(200 mm键合室的情况下为200 mm)的基片。该工具支持所有常见的晶圆键合工艺,如阳极,玻璃料,焊料,共晶,瞬态液相和直接键合。易于操作的键合室和工具设计,让用户能快速,轻松地重新装配不同的晶圆尺寸和工艺,转换时间小于5分钟。这种多功能性非常适合大学,研发机构或小批量生产。键合室的基本设计在EVG的HVM(量产)工具上是相同的,例如GEMINI,键合程序很容易转移,这样可以轻松扩大生产量。
二、特征
带有150 mm或200 mm加热器的键合室
压力和温度均匀性
与EVG的机械和光学对准器兼容
灵活的设计和研究配置
从单芯片到晶圆
各种工艺(共晶,焊料,TLP,直接键合)
可选涡轮泵(<1E-5 mbar)
可升级阳极键合
开放式腔室设计,便于转换和维护
EVG501 晶圆键合机兼容试生产需求:
同类产品中的低拥有成本
开放式腔室设计,便于转换和维护
小占地面积的200 mm键合系统:0.8㎡
程序与EVG HVM键合系统*兼容
三、参数
| 参数名称 | 参数值 |
|---|---|
| 大键合力 | 20 kN |
| 加热器尺寸 | 150 mm(最小为单个芯片);200 mm(最小100 mm) |
| 真空 | 标准:0.1 mbar;可选:1E-5 mbar |
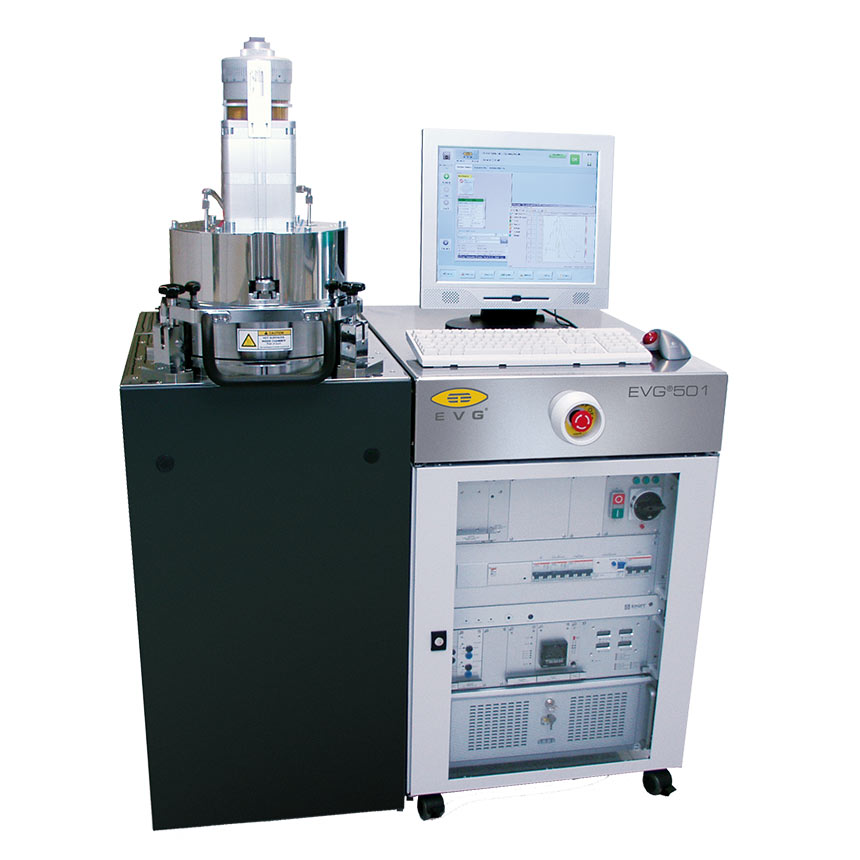
EVG501是一款专为学术研究、研发机构及小批量生产设计的高度灵活的手动晶圆键合系统,兼容单芯片至150 mm(可选200 mm键合室)基片,支持阳极键合、玻璃料、共晶、焊料、瞬态液相(TLP)及直接键合等多种主流键合工艺。开放式腔室设计使得晶圆尺寸与工艺类型切换可在5分钟内完成,拥有成本低,占地面积仅0.8㎡,非常适合多项目交替开展的实验室环境。
在实际选型时,用户可根据样品尺寸选择150 mm或200 mm加热器,并根据真空需求选配标准0.1 mbar或高真空涡轮泵(<1E-5 mbar)配置;若涉及玻璃-硅阳极键合,可升级阳极键合模块。
设备与EVG GEMINI等量产型键合机的工艺程序兼容,便于后续工艺向大批量制造转移。在配套支持方面,我们可协助进行键合工艺参数开发(如温度、压力、气氛设定)、提供对准器(机械或光学)的选配建议,并支持从单芯片工艺验证到小批量试产的全流程方案设计。
产品咨询